산업용 WLI-AFM 측정의 완전 자동화
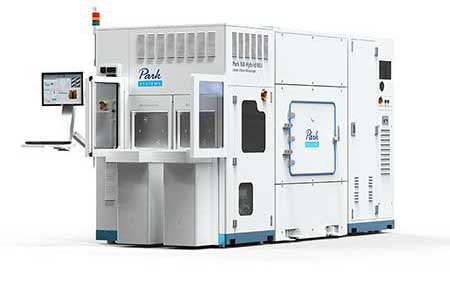
파크시스템스 NX-Hybrid WLI 장비는 WLI와 AFM 각각의 기술이 가지는 장점을 상호 결합하고 단점을 보완하여 하나의 장비로 통합한 세계 최초의 하이브리드 솔루션입니다. 반도체 전공정은 물론 넓은 범위에 걸쳐 미세 구조 측정이 필요한 후공정 및 패키징 분야까지 최첨단 소자 개발과 공정 최적화를 위한 나노 측정기술 제공하는 장비입니다.
대표적 반도체 계측기술의 상호 보완
- WLI: 백색광 간섭계(White Light Interferometry)는 넓은 영역을 빠르게 측정할 수 있는 광학기술
- AFM: 원자현미경(Atomic Force Microscopy)은 물질의 광학적 특성에 관계없이 고분해능 표면 측정이 가능한 scanning probe 기술
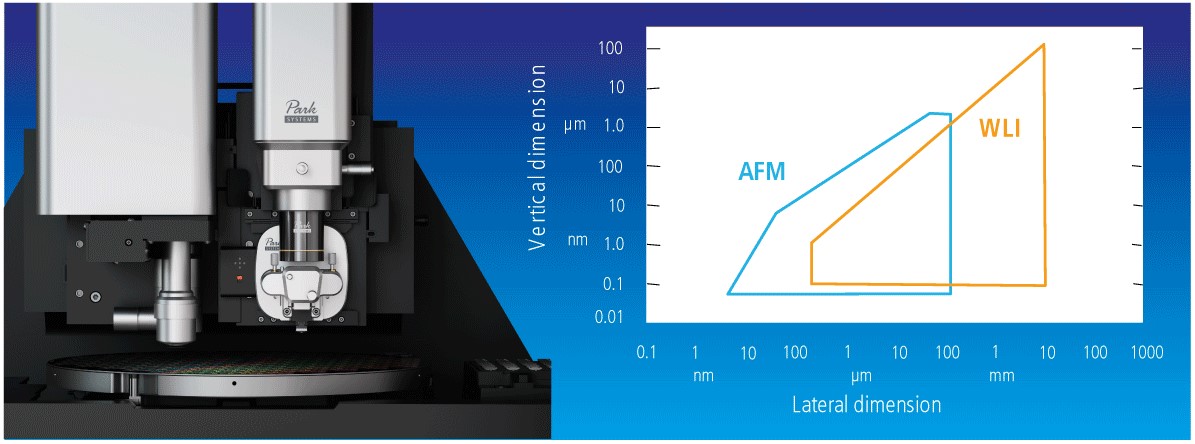
| Measurement Area | Speed | Lateral Resolution | Vertical Resolution | Accuracy | |
|---|---|---|---|---|---|
| WLI | Large | High | Low | High | Low |
| AFM | Small | Low | High | Very High | High |
| WLI | AFM | |
|---|---|---|
| Measurement Area | Large | Small |
| Speed | High | Low |
| Lateral Resolution | Low | High |
| Vertical Resolution | High | Very High |
| Accuracy | Low | High |
WLI and AFM complement each other in field of view, resolution, and speed
일반적인 WLI의 해상도와 정확도보다 높은 성능을 요구하는 WLI 어플리케이션들
- Advanced CMP metrology and monitoring
- Advanced packaging
- Hot-spot and defect detection on full reticle die
- Wafer level metrology
넓은 측정 영역 및 높은 처리량을 요구하는 AFM 어플리케이션들
- In-line Wafer Metrology
- Long Range Profiling for CMP Characterization
- Sub-Angstrom Surface Roughness Control
- Wafer Inspection and Analysis
NX-Hybrid WLI 특징
Park WLI 시스템
- WLI 모드와 PSI 모드 지원 (전동식 필터 교환)
- 지원 가능한 대물렌즈 배율: 2.5X, 10X, 20X, 50X, 100X
- 전동식 선형 렌즈 교환 (2개)
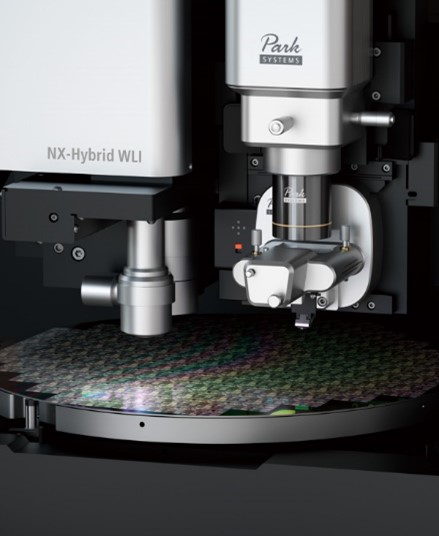
WLI (백색광 간섭계)
- 미라우 렌즈를 통한 빛의 간섭신호 변화로부터 시료의 위치별 높이와 표면 형상 측정
- 백색광 간섭계(WLI) 및 위상 전이 간섭계(PSI) 기술이 표면 분석에 널리 사용
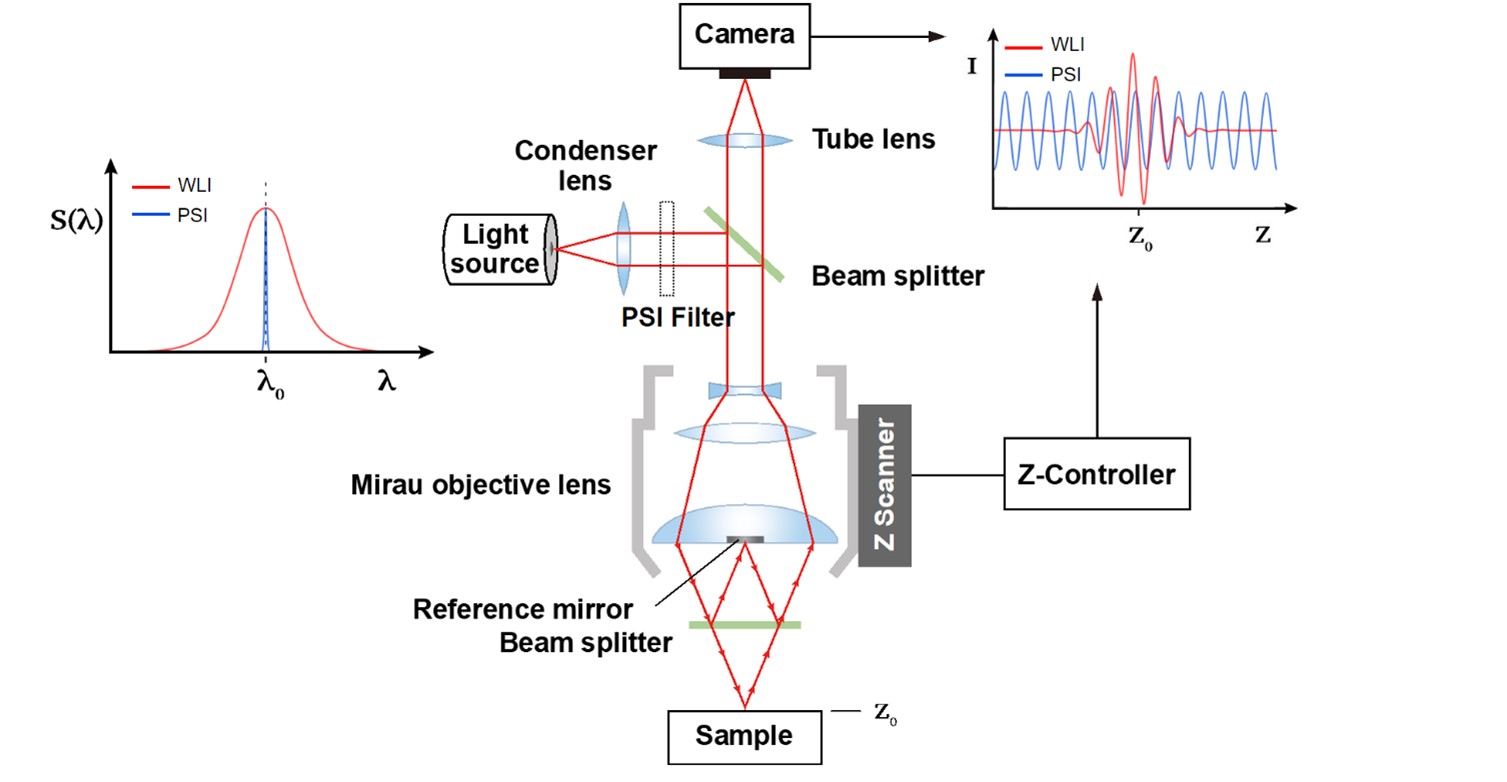
NX-Hybrid WLI 어플리케이션
핫스팟 검출 및 검사
- 레퍼런스 시료와 실제 시료의 측정 결과 비교를 통한 핫스팟 검출
- WLI를 이용한 빠른 "핫스팟 감지"와 고해상도 AFM 측정의 결합으로 넓은 영역에서의 결함(defect)를 빠르게 찾아내고 분석 가능

×




