Friday, April 24, 2020
- 3:00 pm
(EDT)
Boston, New York - 12:00 pm
(PDT)
San Francisco, LA - 8:00 pm
(GMT)
London - 9:00 pm
(CET)
Paris, Rome
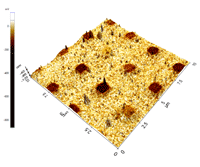
Surface Potential
3D overlay of surface potential image on topography of polymer patterned array material deposited on silicon substrate.
Park Systems Weekly Demo & Chat Sessions is a new series of online, live demonstrations of Park AFM Systems hosted by the Park Systems Technical team. Each week, an engineer from the technical team will lead a short, specific demo and then discuss it with attendees. This is the second session in the new series.
Measuring the electrostatic interaction between the atomic force microscope (AFM) tip and sample is a common technique used to characterize electrically sensitive samples. To characterize the actual potential between tip and sample, kelvin probe force microscopy (KPFM) is used. KPFM is currently standard on Park NX Series microscopes and the baseline technique is supported as the standard for KPFM. Using current NX hardware, however, it is possible to explore other advanced methods of gathering this same KPFM signal, each with their own benefits and tradeoffs. This session will demonstrate how to use advanced KPFM techniques, using current AFM hardware, and explore the advantages of working with these advanced techniques.

Presented By :
Ben Schoenek, Sr. Technical Service Engineer, Park Systems
Ben Schoenek is a Senior Technical Service Engineer for Park Systems, where he focuses on service and support of AFM systems for Park’s research user base. He received his Master’s in Physics from Auburn University, and holds a B.A. in Physics from Kenyon College.






