Lennaert Wouters1, Albert Minj1,2, Umberto Celano1, Thomas Hantschel1, Wilfried Vandervorst1,2, Kristof Paredis1
1IMEC, Leuven, Belgium
2Department of Physics and Astronomy, University of Leuven, Leuven, Belgium
はじめに
走査型拡がり抵抗顕微鏡(SSRM)と走査型キャパシタンス顕微鏡(SCM)はどちらも、二次元キャリアプロファイリングのための確立された走査型プローブ顕微鏡をベースに した測定モードです。SSRMとSCMの開発は主に、静電容量電圧(C-V)測定、二次イオン質量分析(SIMS)、拡がり抵抗プロファイリング(SRP)などの1Dキャリア/ドーパント プロファイリング技術の2D代替品を探しているマイクロエレクトロニクス業界によって推進されました。SSRMでは、プローブをスキャンしながら、ナノスケールのチップと サンプルの接触を介して流れる電流の抵抗値を測定します。その高い感度と空間分解能の鍵は、チップ先端の下に接触時の圧力によって誘発される金属ポケットが存在すること により、チップとサンプルは(ほぼ)オーミックな接触をすることです。測定された抵抗値は、拡がり抵抗によって支配され、したがって、局所的なサンプルの抵抗率pに 依存します。
Rspreading = ρ/4a,
ここで、aは接触の大きさを表します。SSRMの主な利点には、非常に高い空間分解能(~1 nm)と、高い感度とダイナミックレンジ(1014-1020 cm-3)があります。 SCMでは、プローブをスキャンさせながら、高周波静電容量センサーを使用して、チップとサンプル間の小さな静電容量の変動(~10-21F)を測定します。 高濃度にドープされた領域は低い差動容量dC/dVを示しますが、低濃度にドープされた領域は比較的大きな静電容量の変化を示します。SCMの主な利点としては、 n型とp型がdC/dC信号で逆位相を示すため、広いダイナミックレンジとキャリアタイプが感度よく測定できることが挙げられます。
どちらの方法でも、プローブとサンプル表面の詳細情報が欠落しているため、測定値をキャリアの定量値に直接変換することは簡単ではありません。 そのため、既知の標準に対する校正は、一般的に、抵抗/微分容量を抵抗率/キャリア濃度に変換するための最も簡単な方法となります。
実際、どちらの手法も長所と短所がありますが、補完的ともいえます。SSRMは最高の空間分解能を実現する一方、SCMはキャリアタイプを高感度に検出します。
今日の最先端デバイスがサブ10nmノードに突入すると、材料とデバイスの特性評価に対する必要条件が限界に達し、測定を成功に導くためにサンプルの前処理や測定環境など、測定におけるあらゆる側面を最適化する必要があります。
このアプリケーションノートでは、次の3つのサンプルによって、SSRMおよびSCMアプリケーション用のパーク・システムズ[1]のPark NX-Hivac 原子間力顕微鏡(AFM)のパフォーマンスを確認していきます。
1. P型ドープシリコンキャリブレーションサンプル(imec CS08-SiB):既知のいくつかのドーピング濃度のホウ素ドープエピタキシャルシリコン層(~600 nm)で構成されたサンプル(図1)。
2. N型ドープシリコンキャリブレーションサンプル(imec CS01-SiAs):既知のいくつかのドーピング濃度のヒ素ドープエピタキシャルシリコン層で構成されたサンプル(図5)。このサンプルには、スタックに埋め込まれたp型ドープ層が追加されています。
3. 埋め込み酸化物サンプル:高濃度にドープされたSi層とポリSi層の間に挟まれた0.5 nmの酸化物層(図2)。
上記のサンプルは、Park NX-Hivac 原子間力顕微鏡で測定され、imec Full Diamondプローブを使用して真空条件 (~5e-5 mbar) で測定されました[2]。
SSRM-基本性能
まず、SSRM測定の再現性を調べるために、p型キャリブレーションサンプルを測定します。図1は、シリコンのSSRM測定を通して優れた再現性が実現できていることを 示しています。高濃度にドープされた層の方がより再現性に優れていることに要注目です。加えて、同一のスキャンパラメータの場合、通常、 大気中では15~20%程度の偏差に留まることから、高真空条件ではさらに高い再現性を実現できることがわかります。

図1:真空中で行われたp型ドープシリコンキャリブレーションサンプルのSSRM測定。色付きの抵抗断面プロファイルは単一ラインスキャンから取得され、黒い線は5つのスキャンラインの平均を表します。再現性は紫色でプロットされています(右Y軸)。
次に、SSRMの分解能を評価するために、埋め込み酸化物サンプルを測定します。図2は、シリコンに埋め込まれた0.5 nmの酸化物層が、 抵抗の増加としてSSRM測定で簡単に観察できることを示しています。薄い酸化物の抵抗が2倍になることは、電気的接触の半径が酸化物の厚さと同じであることを示しており、 サブナノメートルの分解能を実現します[2]。
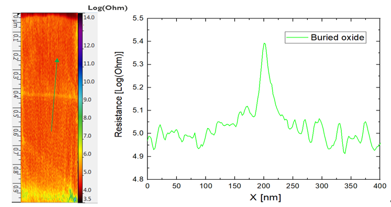
図2:高濃度にドープされたSi層とポリSi層の間に挟まれた0.5 nm酸化物層での高分解能SSRM測定。抵抗の断面プロファイルは、単一のスキャンラインから取得されます。
最後に、p型校正サンプルを同じプローブを使用して大気中および真空中で測定し、真空環境でSSRM測定を実行する利点を検証します。結果は図3に要約されています。予想通り、同様の品質の画像を取得するには、真空から大気中に出すと、導電性チップとサンプルの間で、電気的に良好な状態にするための接触圧は、ほぼ50%の増加を必要としました。この観察は、チップ先端の下にある金属ポケットが、大気中と比較して、真空中でより低い圧力で誘導されることを示唆しています。したがって、真空環境での測定は、チップにかかる力を小さくして行うことができます。これにより、チップの摩擦が少なくなり、分解能が高くなります[2]。

図3:同じプローブを使用して真空および大気中で行われたp型ドープシリコンキャリブレーションサンプルのSSRM測定。抵抗の断面プロファイルは、50スキャンラインの平均値にわたります。
上記の結果から、Park NX-Hivac AFMで行われたSSRM測定の再現性と分解能は非常に高く、チャンバー内の真空条件は再現性のあるSSRM実験を実施するのに有益であると結論付けることができます。
SSRM-デバイス測定と較正
一般に、キャリブレーションサンプルでは、未知のサンプルの抵抗マップをキャリア濃度マップに変換できます。そのために、キャリブレーションサンプルは、対象のサンプルと同じプローブとスキャンパラメータを使用して測定されます。例として、図4に、太陽電池のn型ドープシリコン層の抵抗とキャリア濃度のマップが示されています。

図4:太陽電池サンプルのn型ドープシリコン層のSSRM抵抗とキャリア濃度マップ。
キャリア濃度マップは、図5に示す検量線を使用して、抵抗マップから計算されます。抵抗データポイントは、既知のドーピングレベルで5つの層にわたって測定された平均抵抗値から取得されます。検量線は、これらのデータポイントの補間によって取得されます。
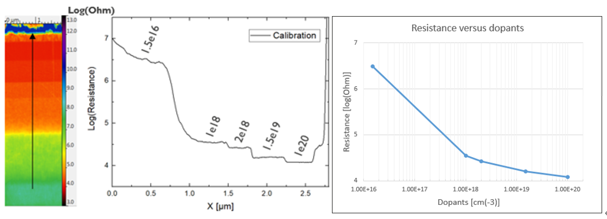
図5:n型ドープシリコンキャリブレーションサンプルでのSSRM測定。抵抗断面プロファイルは、50本のスキャンラインの平均です。抵抗 対 ドーパントのデータポイントは、キャリブレーションサンプルの既知のドーピングレベルで5つの層にわたって測定された平均抵抗値から取得されます。
サンプルと標準の両方での良好な測定の再現性が得られることにより、キャリアレベルが不明なサンプルのアクティブキャリア濃度を正確に測定できると結論付けることができます。
SCM
N型ドープシリコンキャリブレーションサンプルは、Park NX-Hivac AFMでのSCMの性能を評価するために使用されます。このサンプルには、n型エピタキシャル層の隣に、基板とn層の間に挟まれたp型ドープ層もあります。
図6は、n型キャリブレーションサンプルのSCM測定から得られたdC/dV振幅とdC/dV位相マップをそれぞれ示しています。位相マップから、n層とp層を明確に区別できます。ドーピング濃度が異なる様々なn型層も、dC/dV振幅マップで明確なコントラストを示しています。結果として、空間分解能がSSRMほどよくない場合でも、SCMのキャリア濃度感度とキャリアタイプのセンシング能を示しています。
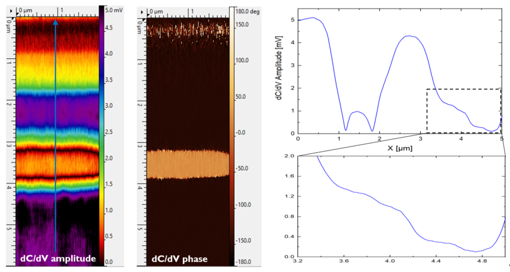
図6:n型ドープシリコンキャリブレーションサンプルでのSCM dC/dV振幅および位相測定。dC/dV振幅断面プロファイルは、50本のスキャンラインの平均から取得されます。
Siに加えて、SCMのもう一つの興味深いアプリケーションは、Ⅲ-V族スタックです。図7に、ドープされたInGaAsスタックのSCM測定の結果を示しています。これらの結果により、キャリア濃度とキャリアタイプに関する情報が得られています。
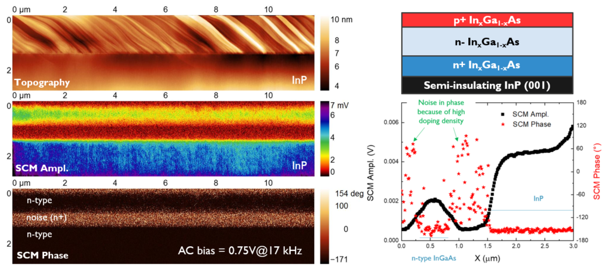
図7:ドープされたInGaAsスタックでのSCM測定。dC/dVの振幅と位相の断面プロファイルは、100本のスキャンラインの平均から取得されます。
まとめ
この研究は、走査型拡がり抵抗顕微鏡(SSRM)と走査型キャパシタンス顕微鏡(SCM)が、 サブ10 nmノードに入る最先端デバイスのキャリアプロファイリングの課題に対応できることがわかります。 この実験により、Park NX-Hivacは、高真空環境でのSSRMやSCMなどの電気SPMモードを実装することで、 縮小し続けるデバイスサイズの課題に対応する強力なツールであることがわかりました。 さらに、Park NX-Hivacを使うことで、ノイズが大幅に低減され、SSRM測定の偏差が6.1%以内収まっていると結論できます。
参考文献
[1] Park NX-Hivac, Retrieved from https://parksystems.com/products/small-sample-afm/park-nx-hivac?highlight=WyJueC1oaXZhYyIsIm54LWhpdmFjJ3MiXQ==
[2] Hantschel, T., et al. Diamond scanning probes with sub-nanometer resolution for advanced nanoelectronics device characterization, Microelectronic Engineering 159, 46-50 (2016).
[3] Eyben, P. et al. Fundamentals of Picoscience, Subnanometer Characterization of Nanoelectronic devices. Edited by Sattler, K.D., CRC Press (2014)




