Advanced Capabilities for Industrial & Research AFM Applications
-
300 mm Wafer Measurement Supporting Advanced Applications
Fully capable of measuring up to 300 mm wafers, it supports a wide range of advanced AFM applications, including the optionally available nano-IR technology.
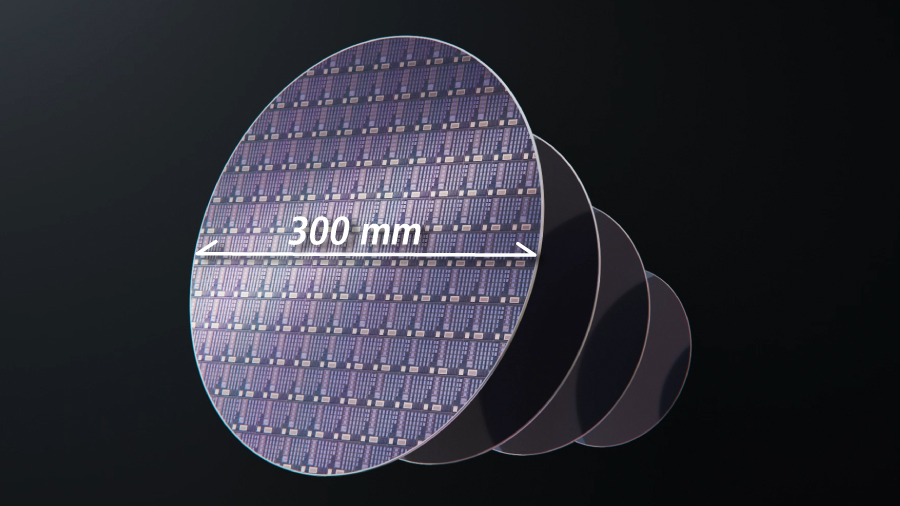
-
Specialized Industrial R&D Applications
Specialized industrial R&D applications with long-range surface roughness profiling, recipe-based routine measurements and a rotatable stage.

-
Enhanced Optical Sample Visualization
Enhanced sample visualization with optional advanced off-axis optical configurations.

-
Integrated Industrial-grade Facility
Integrated industrial-grade facility featuring a facility controller, a signal tower with an emergency-off unit, and optional contamination control solutions using a fan filter unit.